TMC2025观察 | 功率半导体创新技术的20个前瞻故事(中篇)
以下完整内容发表在「SysPro电力电子技术」知识星球-《TMC2025记录|功率半导体创新技术》系列- 文字原创,素材来源:TMC 现场记录、厂商官网- 本篇为节选,完整内容会在知识星球发布,欢迎学习、交流
导语:6月初参加了第十七届国际汽车动力系统技术年会(TMC2025),作为年会核心板块的“新能源汽车及功率半导体协同创新技术论坛”,汇聚了英飞凌、Yole、比亚迪、吉利、理想、芯联集成、采埃孚、罗姆、ST等全球顶尖企业,以及中国科学院、复旦大学等科研机构,围绕第三代/第四代半导体材料应用、SiC/GaN功率模块先进封装革命、车规级芯片自主化等议题展开深度研讨。
从SiC在电驱动系统的前沿应用,到CIPB功率芯片嵌入式封装从实验室到量产的创新突破;从基于氮化镓PCB嵌埋封装在混合动力汽车的实践,到SiC功率模块先进封装技术的最新成果。全方位呈现行业创新活力这场技术盛宴不仅揭示了功率半导体如何重塑新能源汽车的“心脏”,更勾勒出未来三年行业技术路线图与产业生态重构方向在哪里?
我会用"三部曲"解读本次TMC年会关于功率半导体相关议题的主要内容,看看这一年宽禁带功率半导体发生了哪些有趣的故事?出现了哪些前瞻性的解决方案?又带来了怎样的技术革新?本篇为第二曲。

图片来源:TMC
目录
TMC2025观察 | 功率半导体创新技术的20个前瞻故事(上篇)
TMC2025观察 | 功率半导体创新技术的20个前瞻故事(中篇)
9. 大尺寸塑封SiC模块:可靠性验证与车规级量产挑战
10. 理想汽车自研碳化硅功率模块
11. 采埃孚芯片内嵌(CIPB)技术及展望
12. 极致成本、极致体积主驱电功率砖解决方案
13. 电驱应用SiC模块的发展趋势和核心竞争力
14. 无压银烧结在功率模块的应用
TMC2025观察 | 功率半导体创新技术的20个前瞻故事(下篇)
|SysPro备注:本文为概述,更多记录与解读请在知识星球中查阅
TMC2025观察 | 功率半导体创新技术的20个前瞻故事
(中篇)
09 国扬电子
大尺寸塑封SiC模块:可靠性验证与车规级量产挑战
扬州国扬电子的副总经理刘奥先生,为我们带来了关于“大尺寸塑封SiC模块:可靠性验证与车规级量产挑战”的主题报告。
在SiC MOSFET技术路线方面,主要分为DMOSFET和UMOSFET两种结构,不同厂商有着各自的技术侧重。而对于SiC MOSFET的关键科学问题,主要集中在材料缺陷、应力、掺杂的综合调控及其与功率器件性能的关联规律
1;MOS沟道输运特性提升机制,即导通电阻 - 击穿电压的最优耦合关系
2;以及电、热、湿气机械综合应力及恶劣工况下模块失效机理
3,以便对芯片和模块进行可靠性加固。
图片来源:国扬电子
在模块设计上,以国扬电子推出的两款全塑封模块为例,设计过程中需要重点关注模块的寄生电感。通过实测和仿真相结合的手段,确保模块的寄生电感满足设计要求。同时,PC能力循环、H3TRB(高温高湿反偏试验)、TST(温度循环试验)能力等都是关键考核性指标。
 图片来源:国扬电子
图片来源:国扬电子
进一步地,刘奥先生在PC能力循环、TST能力提升、均流能力提升、短路测试与结温标定方面做了深入浅出的讲解,为系统级应用提供了详实的依据。特别针对客户关心的问题,如SiC MOSFET正负电压不对称问题,为什么实际上负压没有写到正压那么高?在评价模块出流能力时,不能仅仅看标称的电流值,还应关注规格书上的标称参数?背后依据是什么?在SiC的耐击穿能力方面,各厂家在设计SiC模块时,击穿电压一般要如何对待?最后,从Si转向SiC时,需要注意哪些内容?
图片来源:国扬电子
从产业基础来看,国扬电子作为封测公司,其母公司中国电子科技集团在SiC芯片生产方面具有强大的实力。国扬电子实现了从外延片到SiC芯片,再到模块的内部内循环,协同重点实验室部门、电力电子部和国扬电子三个部门,共同推动SiC产业的发展。
在技术迭代方面,从早期的平面MOSFET到沟槽型SiC MOSFET,再到未来计划发展的超结型SiC MOSFET,不断追求更低的比导通电阻,以满足电网等高压领域的应用需求。同时,模块也在向全塑封、扁平化方向发展,计划推出性能更优的SiC模块。
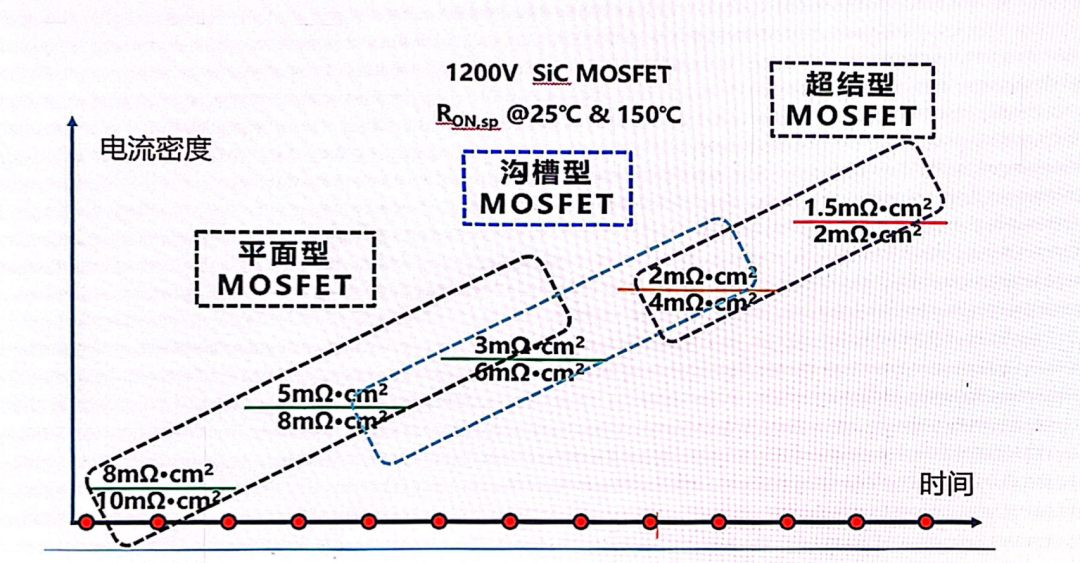 图片来源:国扬电子
图片来源:国扬电子
|SysPro备注:以上为概述,完整记录与解读知识星球中发布
10 理想汽车
理想汽车自研碳化硅功率模块
理想汽车动力驱动电力电子开发总监袁宝成先生,为我们带来了“理想汽车自研碳化硅功率模块”这一主题。理想汽车在2021年年底正式立项自研碳化硅功率模块,经过三年半的开发,该产品在2024年4月份正式批产,并将很快搭载纯电车型对外批产交付。

图片来源:理想汽车
理想汽车开发功率模块主要基于三个方面的考虑:一是作为车企,希望通过自研掌握核心技术,提升产品竞争力;二是开发具有优势的功率模块,以满足自身产品的需求;三是应对开发过程中的各种挑战,实现技术突破。
理想汽车该功率模块采用半桥塑封、全桥结构,尺寸小且容量大,系统电感达 10nH,这是如何实现的呢?袁先生从芯片银烧结、铜夹互连、半桥塑封,经气相焊连封闭铜冷板并采用基板直连技术等角度做了阐述,这些技术方案对于提升模块性能起到了关键作用。

图片来源:理想汽车
此外,电气设计,聚焦提高开关速度,铜夹异型设计补偿空间不对称,三颗并联芯片间用电压均衡线确保电气并联可靠性,左右独立控制引脚降低 AMB 走线面积、支持混合模块开发。散热设计,用封闭铜冷板,嵌焊形成封闭结构,消除泄漏风险,减少零件与组装工序,组装工序减 40%,模块面积降 50%,还具备领先行业的升压功能。
 图片来源:理想汽车
图片来源:理想汽车
理想汽车认为,系统电感对 SiC 模块更重要,通过优化相关设计使续航提升 1%。理想汽车从电容、模块、互联技术角度进行了系统优化。
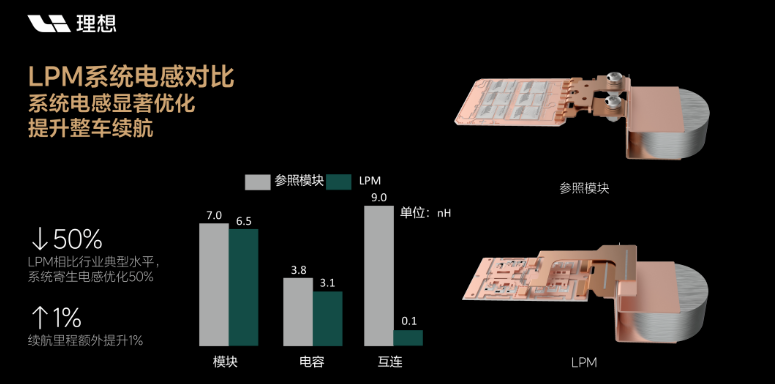
图片来源:理想汽车
在高质量、高可靠性上,理想汽车加大验证数量,生命周期超1800 只全桥验证,超过了一般意义上的10倍以上;开发了早期寿命分析模型;生产工艺100%自动化;多道检测及老化保证质量(AOI光学检测、SAT和AXI检测,以及芯片、模块级老化等手段)。
材料体系匹配上,采用全新涂层解决分层,局部结构强化形成互锁,针对焊接可靠性开槽形成夹槽,还通过大量H3TRB 实验解决了异物控制和离子污染问题。
|SysPro备注:以上为概述,完整记录与解读知识星球中发布
11 采埃孚
芯片内嵌(CIPB)技术及展望
采埃孚电驱事业部电控负责人苑绍志博士,为我们带来了"芯片内嵌(CIPB)技术及展望”这一主题,进一步阐述了采埃孚在这一技术方向上的思考和进展。
苑绍志博士指出,衡量一个模块好与坏,可以从单位面积、单位体积重量下的出流能力,模块层级上的效率和单位电流下的成本,以及单位面积下的芯片出流能力等几个方面进行考量。传统的经典功率模块虽然成熟,但在优化过程中面临着物料成本、生产成本、投资成本、供应链体系复杂度以及实际应用过程中的时间和工程成本等诸多挑战。
 图片来源:ZF
图片来源:ZF
芯片内嵌技术,将芯片合理承载体放到PCB里面,利用PCB的绝缘、机械防护和电气连接等天然优势,实现更小、更轻、更灵活、更可靠的封装形式。然而,该技术也面临着一些挑战,如:没有完整的设计和测试标准,需要精细化多指标的寻优,PCB承载高压高电流后关键材料的选择以及散热和绝缘之间的矛盾等。
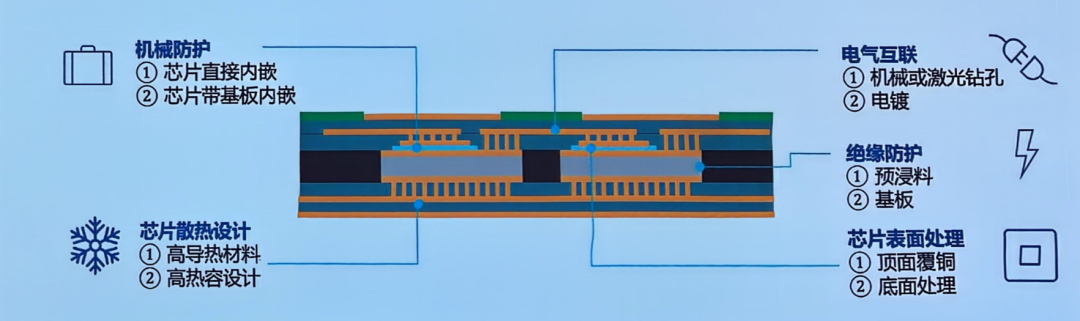 图片来源:ZF
图片来源:ZF
苑博士指出,采埃孚的芯片内嵌方案,设立了非常苛刻的项目目标。包括将功率模块尺寸减小60%,在同等使用条件下芯片出流能力提高30%,具备大批量投产的条件,采用平台化、模块化、可扩展性的理念,适用于不同的半导体封装,并建立成熟的供应链体系。
采埃孚方案的设计精髓在于:非对称式的PCB结构,通过这种结构实现低热阻,同时兼顾可靠性和绝缘矛盾。在可量产设计的关键性能参数方面,热阻从芯片到冷却介质小于0.08,杂散电、均流和结温等参数也表现出色。

图片来源:ZF
基于嵌入式形成的逆变砖以及功率逆变器具有较高的功率密度,当前准备批产的GEN1.0达到160kW/L。在可量产的设计验证方面,进行了大量的材料可靠性、界面可靠性以及标准的AQG测试,测试结果完全可以满足乘用车使用寿命的要求。特别是针对PCB的导电性阳极细丝失效形式,采埃孚形成了一套可靠的机制和平台化方案,测试结果非常喜人。
采埃孚的芯片内嵌技术具有诸多优势,如芯片用量减少30%,产品逆变器尺寸减小60%,同时由于PCB的特性,逆变器可以根据需求设计成各种形状。此外,该技术还为混连技术提供了支持,通过合适的控制策略,在同样尺寸的逆变器下,可以减少80%多SiC的用量,大大降低了成本。
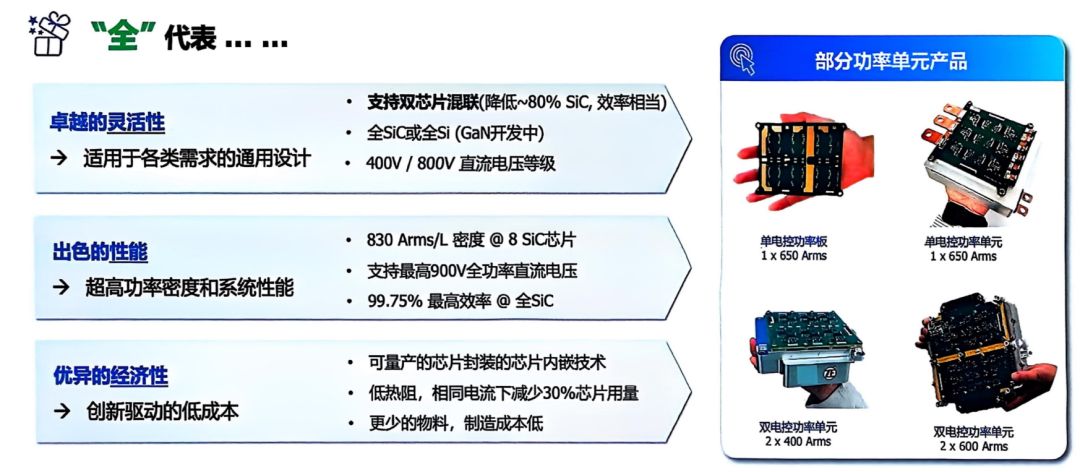
图片来源:ZF
|SysPro备注:以上为概述,完整记录与解读知识星球中发布
12 致瞻科技
极致成本、极致体积主驱电功率砖解决方案
来自致瞻科技的总功刘昌金先生,为我们带来了“极致成本、极致体积主驱电功率砖解决方案”这一主题,聚焦于主驱电控功率模块的成本和体积优化。
目前,主驱功率模块开发周期长、成本验证成本高,不同动力架构和功率等级采用不同功率模块会导致成本高且风险不可控。因此,平台化设计显得尤为重要,通过平台化尽量使一个模块能够覆盖多种动力构型和功率等级,降低开发周期和成本。
同时,SiC和IGBT将长期共存,不同车型对电压等级的需求也不同,这就要求封装能够兼容SiC和IGBT,使电驱系统的形态基本统一。此外,封装成本占比逐年增加,而芯片成本快速下降,这也凸显了降低封装成本的重要性。
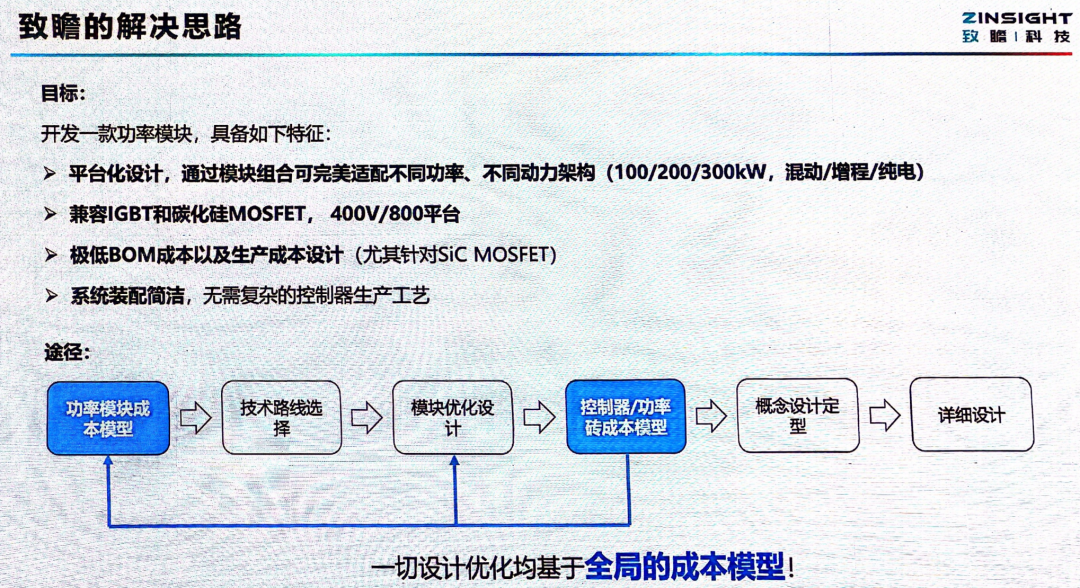
图片来源:致瞻科技
致瞻科技,提出的ZPAK模块是一种全新的设计,采用半桥模块,通过半桥组成全桥。
该模块具有多个特点,刘先生对这些特征进行了详尽的介绍。如:采用立体式的换流路径,实现低杂感,且成本较低;芯占比达到85%,降低了封装成本;巧妙的功率和信号出PIN布局在小尺寸下满足高绝缘安规要求;极简结构和工艺保证极低BOM和工艺成本。

图片来源:致瞻科技
在系统层面,致瞻通过一系列的方法,使ZPAK模块可以非常方便地实现功率的拓展,适用于不同的动力架构和功率等级,大大缩小了功率模块和水冷板等面积,降低了成本。在逆变砖布局方面,从半桥变成全桥,组成逆变砖,再与电机进行端部的连接,组装非常简单。
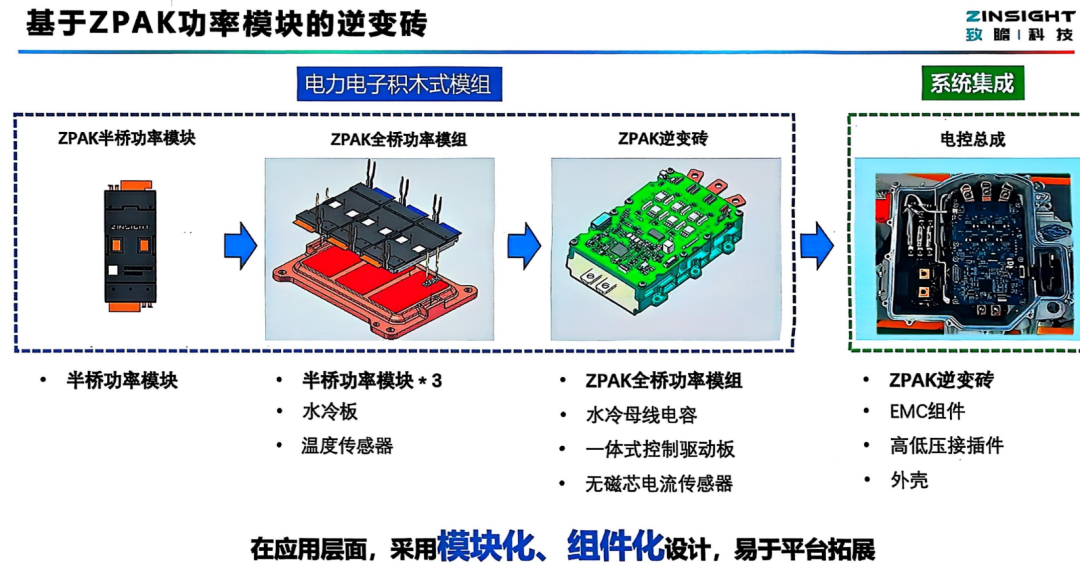
图片来源:致瞻科技
|SysPro备注:以上为概述,完整记录与解读知识星球中发布
13 悉知科技
电驱应用SiC模块的发展趋势和核心竞争力
悉智科技汽车国际BL业务总监王涛先生,带来了“电驱应用SiC模块的发展趋势和核心竞争力”这一主题,深入分析了SiC模块在电驱应用中的发展趋势和核心竞争力。
随着新能源汽车的快速发展,SiC器件在主驱车的应用增长迅速。为了通过技术降本,SiC电驱功率模块需要关注回路电感、高温特性和热阻等关键性能。
降低回路电感可以实现更低的开关损耗,节省整车的电池成本或进一步提升续航里程。提高工作结温可以增加出流能力,进一步降本。优化热阻也可以提升出流能力。目前,悉智指出,SiC功率模块正朝着封闭式或开放式铜/铝散热器上焊接/烧结的塑封功率模块方向发展,同时接口部分需要与主机厂深度定制。
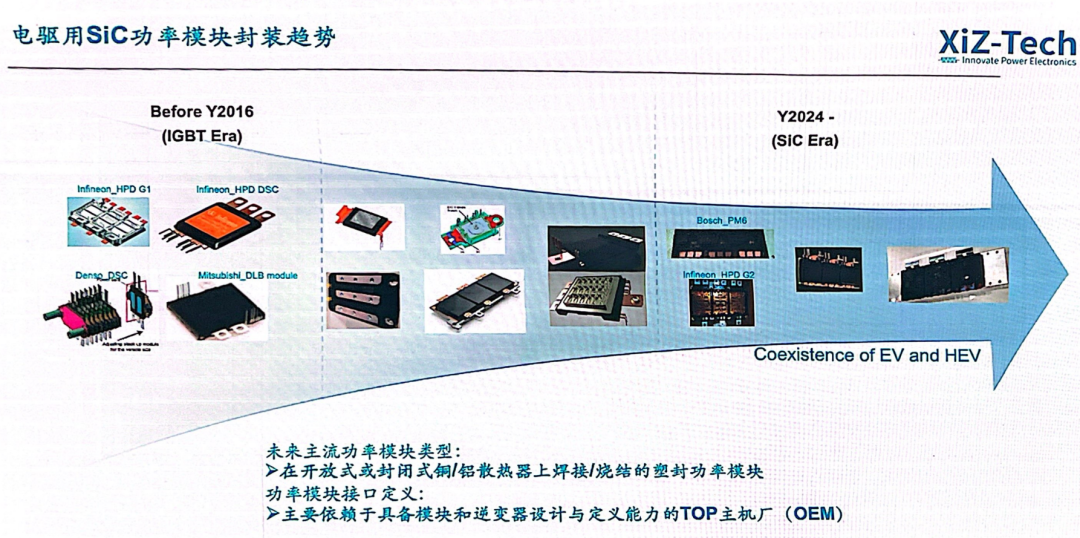
图片来源:悉智科技
在核心竞争力方面,创新的方案设计是关键。例如,悉智科技,通过芯片精流技术、创新的水道技术、串扰优化技术和均流技术等,实现更好的性能指标。关键封装技术开发也是核心竞争力之一,如Cu clip技术具有出流更好、BOM成本更低的优势。此外,量产测试筛选和品质管控同样重要,通过晶圆的老化和功率模块层级老化的测试层级的筛选,确保最终良率。
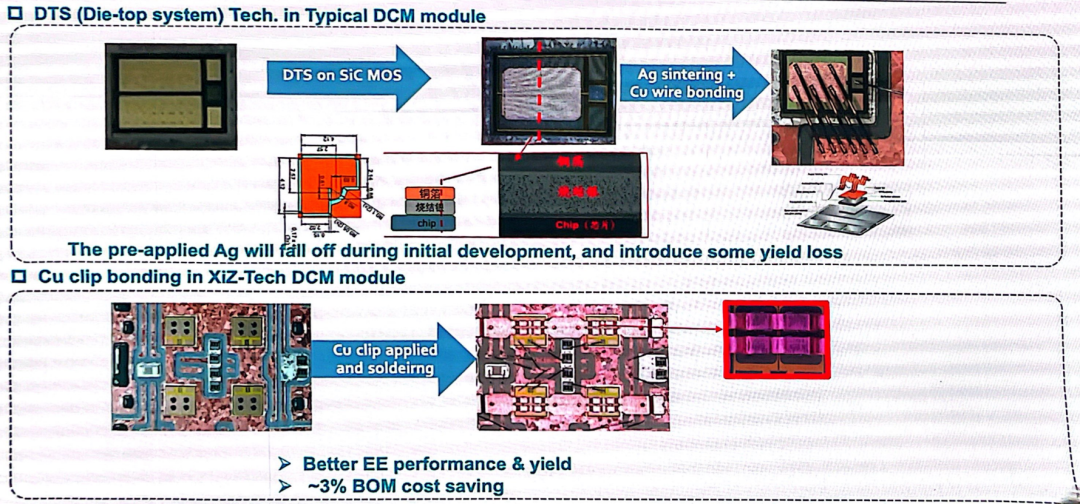
图片来源:悉智科技
|SysPro备注:以上为概述,完整记录与解读知识星球中发布
14 住友电木
无压银烧结在功率模块的应用
苏州住友电木的宋大悦先生,为我们带来了“无压银烧结在功率模块的应用”这一主题,介绍了一种新型的功率模块连接技术。
随着市场对半导体产品需求的增加,对热管理和热应力管理提出了更高的要求。无压银烧结材料作为一种TIM2材料,具有不需要金属紧固件螺丝结合、更好的热扩散效应和更高可靠性等优点。

图片来源:住友电木
与传统的solder和加压全烧结材料相比,无压银烧结材料的BLT较薄,热量能够更快地从AMB和SiC芯片传导到底下的散热片上;能够充分填充散热片和粘结材料之间的缝隙,使热更充分地传导;并且由于部分树脂材料的加入,增加了结合力,减小了模量,降低了内部应力,达到更高可靠性的表现。
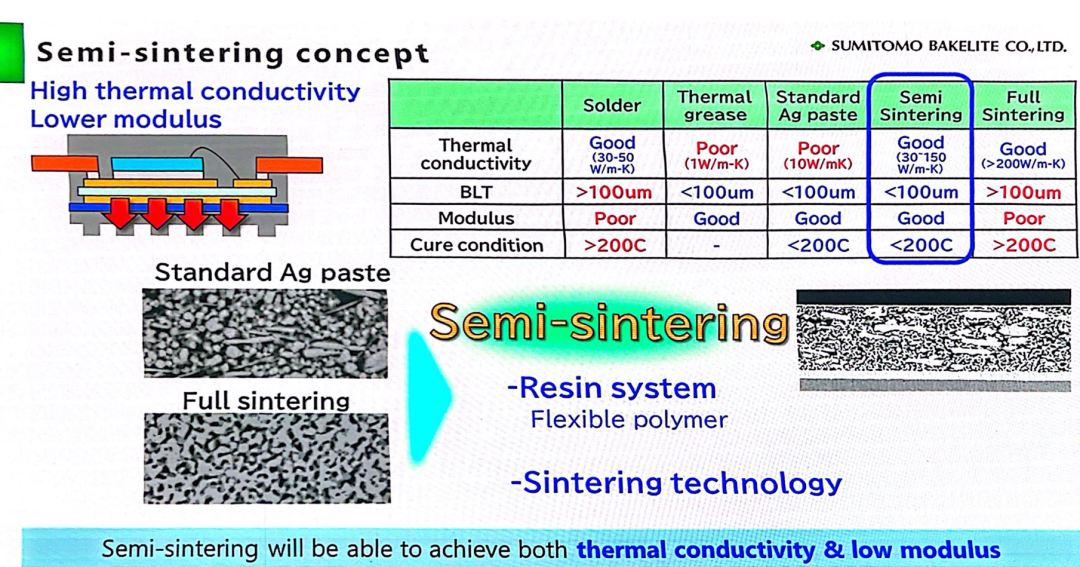
图片来源:住友电木
在制程管控方面,无压银烧结材料也具有一定的优势。它不需要清洗,避免了溶剂、助焊剂等污染问题,且不需要加压,减少了物理加压过程中对芯片的损伤。通过模拟测试,无压银烧结材料在冷热应力考核中的表现优于solder材料。
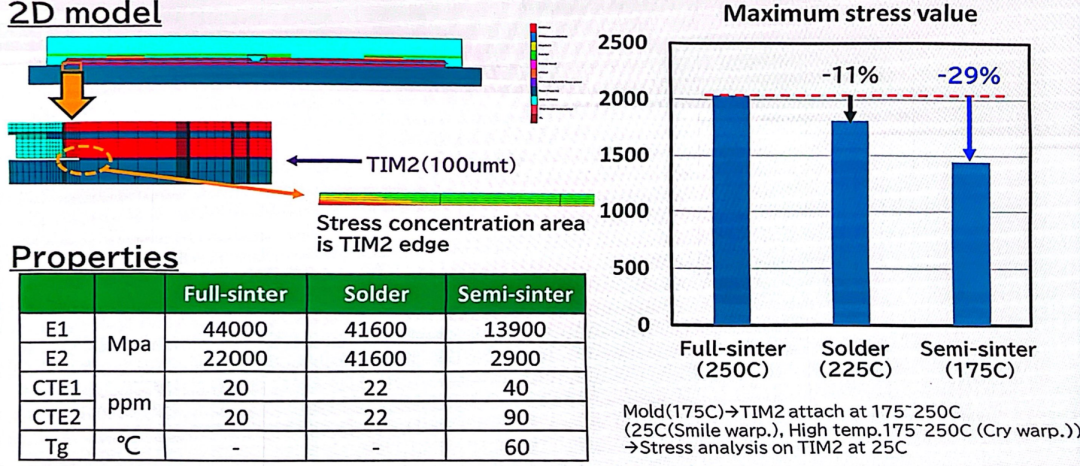
图片来源:住友电木
|SysPro备注:以上为概述,完整记录与解读知识星球中发布